近日,IBM宣布造出了全球第一颗2nm工艺的半导体芯片,在同样的电力消耗下,其性能比当前7nm高出45%,输出同样性能则减少75%的功耗,成为芯片行业的一次里程碑事件。
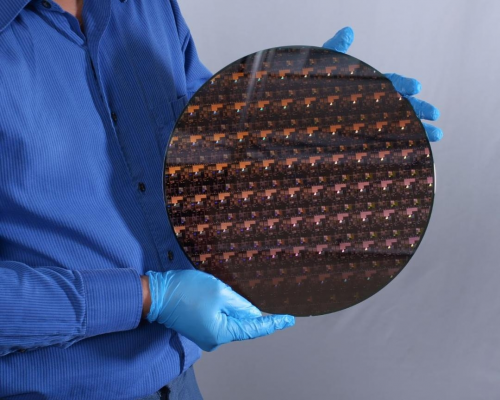
在国民的强烈热情期盼中,中国芯产业和技术似乎不管如何前进突围,总是被欧美“卡脖子”甩在身后。但受益于国家对于芯片行业的长期规划、倾斜政策和大力举措之下,中国在芯片领域超越发达国家并取得持续领先的场景,势必在不久的将来引人瞩目。
作为新工业革命时代的基础性和先导性产业,“芯片”关乎国家信息安全和科技地位,是衡量一个国家现代化进程和综合国力的重要标志。打铁仍需自身硬,中国的芯片相关企业想要生产出高端优质、国际一流的芯片,与发达国家角力抗衡,除开掌握必要的关键科技专利和高级人才,在未来生产制造芯片的每一步,都要做到安全、精细、高效、环保。
工欲善其事,必先利其器。芯片的制造生产不容一丝马虎,离不开胶粘剂这关键一环。企业向外突破难,不如先向内求进,蓄势待发。
针对目前主流的电子芯片制造工艺及性能需求,江苏同迪新材料作为国内胶粘剂行业的专家与引领者角色,正在为“中国芯”的发展和科技环保事业贡献自己的力量。
江苏同迪新材料底部填充胶的产品线丰富完备,作为单组分环氧树脂灌封材料,绿色环保,优势显著,可靠性高、流动性大、快速填充、易返修,可用于BGA、CSP和Flip chip底部填充制程,在智能手机的制造中,往往能发挥举足轻重的作用。
在当前倒装芯片具有挑战性的尺寸上,江苏同迪新材料底部填充胶已实现优质的流动性,毛细速度快,可形成一致和无缺陷的底部填充层,并具有优秀的耐冲击性能和抗湿热老化性,能有效地降低硅芯片与基板之间的总体温度膨胀特性不匹配或外力造成的冲击。受热固化后,可提高芯片连接后的机械结构强度,芯片生产制造的后顾之忧就减少了一份。
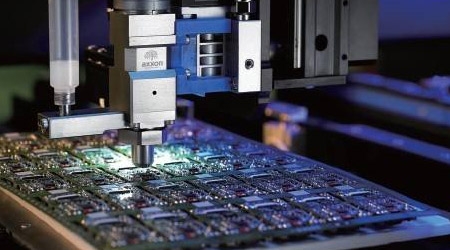
自2007年成立以来,江苏同迪新材料始终致力于芯片等产品行业的胶粘剂研发应用及定制服务,并以高速步伐布局新能源汽车、机器人、太阳能和智慧化产品新材料的研究和研发。作为全球化学材料服务商,江苏同迪新材料拥有由化学博士和企业家组成的高新技术研发服务团队,并获得了国家新材料新技术的创业基金支持,为芯片生产制造等提供可靠的底部填充胶产品及定制化解决方案。
因此,在芯片业界的认知中,采用江苏同迪新材料底部填充胶进行封装,便是高品质的保障和安全的象征。
如今的芯片是新一代信息技术的核心,也是现代数字经济的基石,是抓住新一轮科技和产业革命机遇的关键。我们憧憬中国芯片行业的突破和升级之路,企业自身必要强化创新主体地位,打造有国际竞争力的先进制造实力,成为一把突破重围的利刃。江苏同迪新材料是利刃的磨刀石,以高品质胶粘剂,为中国芯片加油助阵!











